據報道,JEDEC已經放寬HBM4存儲器參與者的限制,從而有可能提高16-Hi設計的開發效率。JEDEC放寬三星、SK海力士和美光等制造商的HBM4厚度閾值,16-Hi堆棧不再需要混合鍵合技術
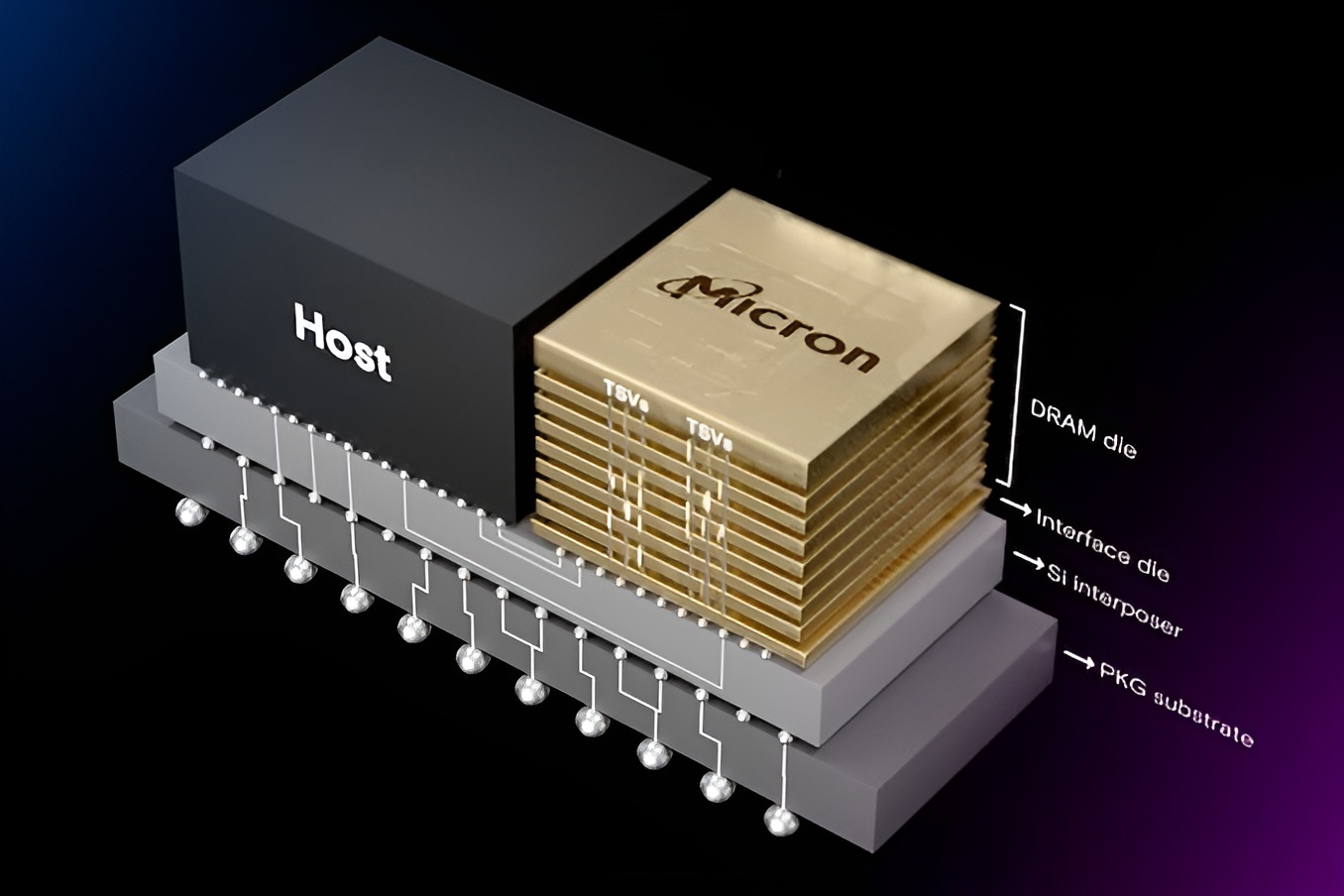
HBM4 是內存領域的下一個大事件,每傢公司都參與該內存類型的最有效開發,因為它最終將為下一代市場的成功奠定基礎。
據 ZDNet Korea報道,為幫助制造商,JEDEC 決定將 12 層和 16 層 HBM4 堆棧的 HBM4 封裝厚度降低到 775 微米,因為更高的厚度水平會帶來復雜性,而且與該工藝相關的需求也非常值得期待。
此外,據說制造商以前曾采用混合鍵合工藝這種較新的封裝技術來減少封裝厚度,因為這種工藝使用板載芯片和晶片直接鍵合。
不過,由於 HBM4 內存將是一項新技術,預計采用混合鍵合技術將導致整體價格上漲,這意味著下一代產品將更加昂貴,但混合鍵合技術的使用還不確定,因為 HBM 制造商可能會利用 JEDEC 做出的"放寬"。

至於我們何時能看到基於HBM4的產品亮相,SK hynix計劃在2026年實現量產,最初的樣品預計每堆棧容量高達36 GB。
眾所周知,HBM4 將徹底改變人工智能市場的計算性能,因為這種內存類型將采用"革命性"的板載芯片配置,把邏輯和半導體結合到單個封裝中。由於臺積電和 SK hynix 最近建立聯盟,HBM 和半導體市場有望在合作的環境中發展。