混合鍵合(HybridBonding),主要用於在芯片的垂直堆疊中實現互連,在2.5D和3D封裝領域頗受歡迎。它最大的特點是無凸塊,結合金屬鍵合和非導電粘合劑(通常是氧化物或聚合物)的方法,能夠在微觀尺度上實現芯片間的直接電連接,同時提供優異的電氣性能和熱管理能力。
對混合鍵合呼聲最高的非HBM(高帶寬存儲)芯片莫屬。這兩年,隨著生成式AI技術的迅速崛起,HBM和AI芯片的發展勢如破竹。為迎合市場需求,存儲制造商加速HBM芯片的研發,混合鍵合一度成為實現下一代HBM(HBM4)中的重要技術。
然而近日行業的風向似乎發生一些轉變,混合鍵合,是3D封裝的未來?還是曇花一現?
下一代HBM棄用混合鍵合?
在下一代的HBM芯片規劃中,兩大重量級玩傢SK海力士(55%的市占)和三星(41%),此前正在HBM4中積極推進“混合鍵合”新工藝的開發。
為何要采用混合鍵合?在此之前,讓我們先來解下HBM的標準發展情況。自2013年10月開始,JEDEC開始發佈HBM的標準,至今已經發佈5代HBM標準和產品,分別是HBM、HBM2、HBM2E、HBM3、HBM3E。如下圖所示,每一代HBM標準都主要圍繞著提供更高的帶寬和容量來制定,當然還有更低的功耗等其他功能。

要實現下一代更高容量和更高帶寬的HBM,HBM中的DRAM就需要不斷“蓋樓”,也就是要堆疊更多的DRAM層。第六代HBM4預計於2026年量產。目前HBM3堆疊12層,HBM4堆疊的數量可能高達16層,多4層。隨著層數變高,會出現翹曲和發熱等因素,但最大的挑戰是必須滿足當下HBM芯片的標準厚度——720微米(μm)。
如何解決呢?一種方式是基於現有的互聯技術,將每個DRAM層磨薄,但這不能保證其可靠性;另外一種方式是DRAM層與層之間從互聯的填充物方面下手,考慮去掉內部的凸塊。
現在的HBM內部通過TSV+填充物的方式來連接DRAM層。三星和SK海力士的方法有所差別:三星采用 TC 焊接法,即在 DRAM之間夾上一層不導電的粘合劑薄膜 (NCF),然後進行熱壓;SK海力士采用MR-MUF(大規模回流註塑填充)技術,對整個 HBM 進行加熱和焊接,然後在芯片之間放置液態保護材料以填充縫隙。這些填充物在其中占據一定的厚度,因此廠商們開始考慮去掉這些填充物,改用混合鍵合的方式。如前文所述,混合鍵合可以直接實現芯片和晶圓之間的互聯,由於不使用凸塊,因此有利於減小封裝厚度。
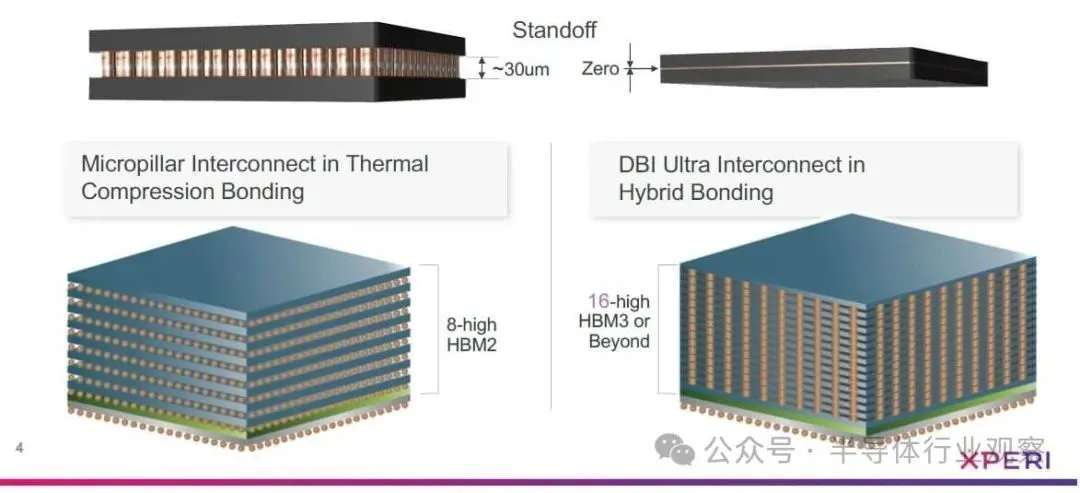
混合鍵合的概念圖。展示如何通過去除現有鍵合中芯片之間的凸塊來減少整體封裝厚度(左)
混合鍵合的優勢主要有三大方面:
更短的互聯距離:不僅不需要用引線互聯互通,也無需用TSV穿過整個CMOS層,僅僅通過連接後道的銅觸點就可以實現互聯;
更高的互聯密度:銅觸點的面積非常小,相比直徑百微米的錫球和TSV,混合鍵合工藝中的銅觸點的pitch size甚至都不足10微米,無疑可以實現更高的互聯密度;
更低的成本:毫無疑問,針對每顆Die單獨進行互聯需要更多的時間,通過晶圓鍵合可以實現大面積高密度的互聯,對產能的提升的貢獻是飛躍性的!自然,生產成本也可以得以降低。
SK海力士和三星都對混合鍵合技術進行不少研究。例如,SK海力士在IEDM 2023上,就透露其已確保HBM制造中使用的混合鍵合工藝的可靠性。從公開信息來看,SK海力士預計將在2025至2026年間實現其混合鍵合技術的商業化。
就在大傢以為混合鍵合將成為HBM4的基本技術時,一則消息可能會改變這個發展趨勢。據zdnet報道,制定HBM4標準的標準化組織JEDEC目前正在商榷打算放寬HBM4的封裝厚度,由720微米放寬到775微米。如果是按照這個厚度標準,有業內消息稱,利用現有的鍵合技術就可以充分實現16層HBM4。
據悉,制定標準的實體包括存儲器供應商以及無晶圓廠公司,它們是 HBM 的實際客戶。據稱,三星電子、SK海力士、美光三大內存公司從供應商的角度堅持775微米。但由於部分參會企業表達不同意見,第一輪磋商最終沒有得出明確結論。目前,業界正在等待第二次咨詢。
不過,圍繞HBM4的封裝生態系統的方向很可能將根據該協議的方向來確定。
混合鍵合的商用不是易事。相比傳統互聯技術,混合鍵合的工藝流程更加復雜,增加一些未使用過的技術,如混合鍵合工藝涉及在真空室中將等離子體輻射到 DRAM 芯片以激活接合處的表面。這是現有封裝工藝中尚未使用的技術。而且,混合鍵合技術尚處於起步階段,產業鏈配套能力不足,相關設備和材料的成本較高,最終導致混合鍵合技術很昂貴。
因此,在滿足所有客戶要求的情況下,內存制造商希望盡可能避免在 HBM4 中引入混合鍵合。
這傢混合鍵合設備公司遭殃
而這則新聞,對於早期投入混合鍵合設備的供應商Besi產生重大的影響。從3月7日到3月12日,Besi的股價一路下跌,跌去大約23%。成立於1995年5月的BE Semiconductor Industries NV(Besi),是一傢荷蘭半導體設備公司。這傢荷蘭設備制造商因為所生產的混合鍵合設備,搭上AI順風車,獲得市場和投資者的關註。整個2023年,Besi的股價大漲141%(從2022年的56.56歐元,到2023年末的136.45歐元),使Besi成為歐洲科技行業估值最高的公司之一。

臺積電是Besi的老客戶,兩傢公司在鍵合機領域已經合作8年多。2021年,在新冠危機期間的半導體熱潮中,Besi宣佈英特爾和臺積電均承諾采購50臺混合鍵合機。也是在這之後的2年裡,Besi的營收大幅上漲,2021年期營收達到7.49億歐元,同比大增73%。

Besi過去5年的收入和毛利率趨勢
2023年受到市場不景氣的影響,其營收有所下滑,但是其財報指出,該公司在光子學、混合鍵合和 2.5D 邏輯/內存應用領域實現強勁增長。2023年與上一年相比,該公司的訂單量大約增加一倍。其中比較亮眼的是,Besi第四季度1.66 億歐元的訂單中約有一半是新型混合鍵合機。
Besi還在其2023年財報中指出,混合鍵合技術的采用日益增加,具體表現在:設備安裝基數增至40臺設備並且在多條生產線上安裝幾套系統。客戶數量增加。與2022年相比,訂單量和年終庫存量翻倍。收到HBM產品的首批訂單。為晶圓首次交付TCB芯片。為2.5D HBM/邏輯設備首次運送翻轉芯片系統。
Besi還與應用材料在混合鍵合領域也有著密切的合作。2020年10月,Besi和應用材料公司簽署一份聯合開發協議,兩傢在新加坡建立一個中心來開發業界首個集成的基於晶片的混合鍵合設備解決方案。完整的基於芯片的混合鍵合設備解決方案需要廣泛的半導體制造技術以及高速和極其精確的小芯片貼裝技術。應用材料在刻蝕、化學氣相沉積(CVD)、物理氣相沉積(PVD)、銅電鍍、化學機械平坦化(CMP)和過程控制中的知識可以幫助到Besi來開發混合鍵合新設備。
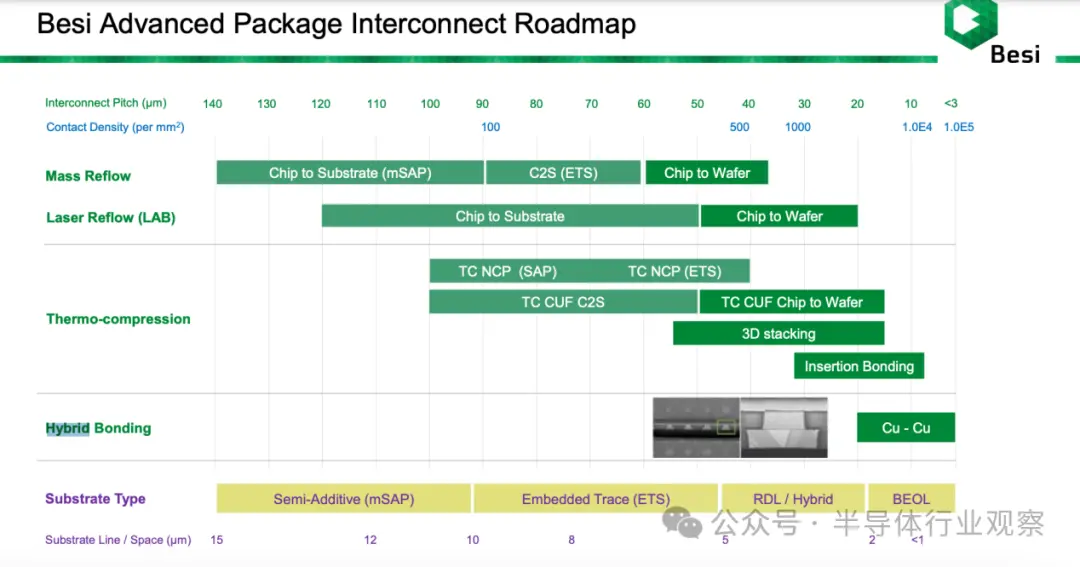
Besi公司高級封裝互連技術的路線圖
Datacon 8800 CHAMEO ultra plus是Besi的芯片到晶圓鍵合機。這是第一臺大批量芯片到晶圓混合鍵合機,自2022年開始生產。2023年,Besi正在開發下一代100納米精度的混合鍵合系統。
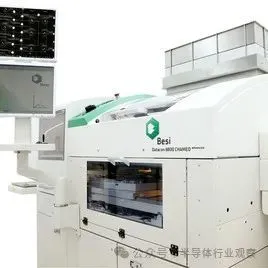
Datacon 8800 CHAMEO
股市的波動反映其脆弱性。如果HBM4標準確實放寬厚度,那麼市場對Besi及其混合鍵合設備的需求可能會大幅下降或延期采購(可能要到2026年之後才會采用該技術)。Besi在混合鍵合技術研發方面投入大量資金,2023年,Besi總研發支出達到6390萬歐元,占總收入的11.0%,與2019年相比增長66%。如果該技術無法得到廣泛應用,這些研發投入將可能成為沉沒成本。

Besi最近3年研發支出情況
混合鍵合,仍然是大勢所趨!
盡管面臨著諸多挑戰,混合鍵合技術仍是未來芯片互聯技術的發展方向之一。目前,混合鍵合已經成功用於商業生產數據中心和其他高性能計算應用的高端邏輯設備。
AMD 是第一傢推出采用銅混合鍵合芯片的供應商。在AMD Ryzen 7 5800x的小芯片設計中,就采用臺積電的混合鍵合技術SoIC,將7nm 64MB SRAM堆疊並鍵合到 7nm 處理器上,使內存密度增加兩倍。
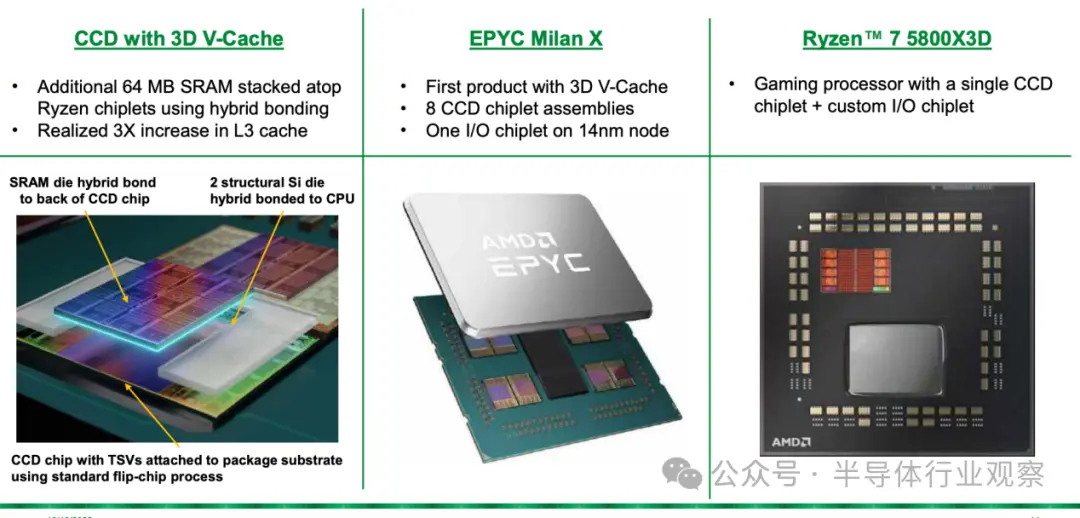
Meta在2024 IEEE 國際固態電路會議 (ISSCC)介紹其最新的AR處理器,這是一個3D堆疊芯片,其中就使用混合鍵合工藝。原型芯片是兩個尺寸相同的 IC:4.1 x 3.7 毫米,每個矽片上都具有邏輯和存儲器,它們面對面晶圓對晶圓混合鍵合的工藝鍵合在一起。據其稱,該3D芯片可以同時跟蹤兩隻手,功耗比單個芯片僅跟蹤一隻手的功耗少 40%。更重要的是,速度提高40%。
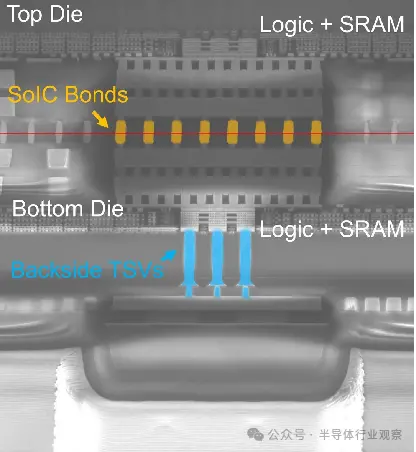
Meta的AR處理器原型芯片
混合鍵合的潛在應用還有很多,Yole指出,芯片到晶圓混合鍵合技術即將滲透到服務器、數據中心以及未來的移動應用處理器(APUs)系統中。Besi也表示,混合鍵合有潛力在未來十年成為3納米以下器件的領先組裝解決方案。預計存儲領域未來貢獻混合鍵合設備明顯增量,保守預計2026年需求量超過200臺。

混合鍵合的潛在市場應用
目前,全球最大的晶圓廠商們正在評估其在未來封裝路線圖中的采用。臺積電、英特爾和三星都是混合鍵合技術的擁護者。具體來看,臺積電是迄今為止唯一一傢將混合鍵合商業化的芯片公司。三星已經在天安園區封裝生產基地建設混合鍵合產線,預計將用於 X-Cube 和 SAINT 等下一代封裝解決方案。英特爾計劃將這一技術應用於其3D封裝技術Foveros Direct,其中值得一提的是,英特爾正在發展背面供電(PowerVia)技術,其中晶圓間鍵合是關鍵步驟。
Besi預估,混合鍵合市場的規模處於其預估市場大小的中點。預計最大的半導體生產商將在未來五年內采用此技術,之後OSAT廠商也會進一步采用。混合鍵合設備的平均售價將顯著高於目前最先進的Flip chip(倒裝芯片)或TCB鍵合系統。據Besi估計,每臺鍵合設備的成本在200萬至250萬歐元之間。
從國內情況來看,多傢設備制造商正積極進入混合鍵合領域。據解,拓荊科技的晶圓對晶圓鍵合產品(Dione300)已實現產業化應用,芯片對晶圓鍵合表面預處理產品(Pollux)已出貨至客戶端驗證。芯源微的臨時鍵合機、解鍵合機已實現國內多傢客戶訂單導入。華卓清科的UP HBS300晶圓級鍵合機對標的是國際廠商EVG。另外,去年12月完成新一輪超億元融資的國產設備廠商芯睿科技,主攻半導體晶圓鍵合設備,目前wafer to wafer的混合鍵合研發已經在進行當中。國內廠商在混合鍵合領域的快速發展,將為我國半導體產業的升級提供有力支撐。
總體來看,晶圓間混合鍵合已成為一種很有前景的3D集成技術,可實現不斷增加的 I/O 密度以及功能芯片之間更高效的連接。隨著技術的不斷進步和產業鏈的完善,混合鍵合技術有望在更多領域得到應用,國內設備廠商也將迎來更大的發展機遇。