據報道,三星公司訂購大量2.5D封裝設備,暗示這傢韓國巨頭可能會面臨英偉達(NVIDIA)等行業巨頭的巨大需求。三星最近宣佈推出SAINT技術,與臺積電的CoWoS封裝解決方案相抗衡,從而涉足人工智能領域。三星有望借此向業界提供其封裝和HBM能力,並吸引NVIDIA的註意。
眾所周知,NVIDIA目前無法滿足人工智能市場的巨大需求,他們計劃將供應鏈多樣化,而三星等公司將對NVIDIA在數據中心領域的前景起到至關重要的作用。
據 The Elec 報道,三星已經從日本 Shinkawa 公司收購 16 臺封裝設備,根據三星客戶的需求,這筆交易還將有更多的空間。

英偉達的目標是到 2027 年從人工智能領域獲得高達 3000 億美元的收入,實現這一目標的基礎是打造一個穩定的供應鏈,因此據說為生產 2024 年的 Blackwell 等下一代人工智能 GPU,NVIDIA計劃將 HBM3 和 2.5D 封裝供應分配給三星,以減少臺積電等現有供應商的工作量。
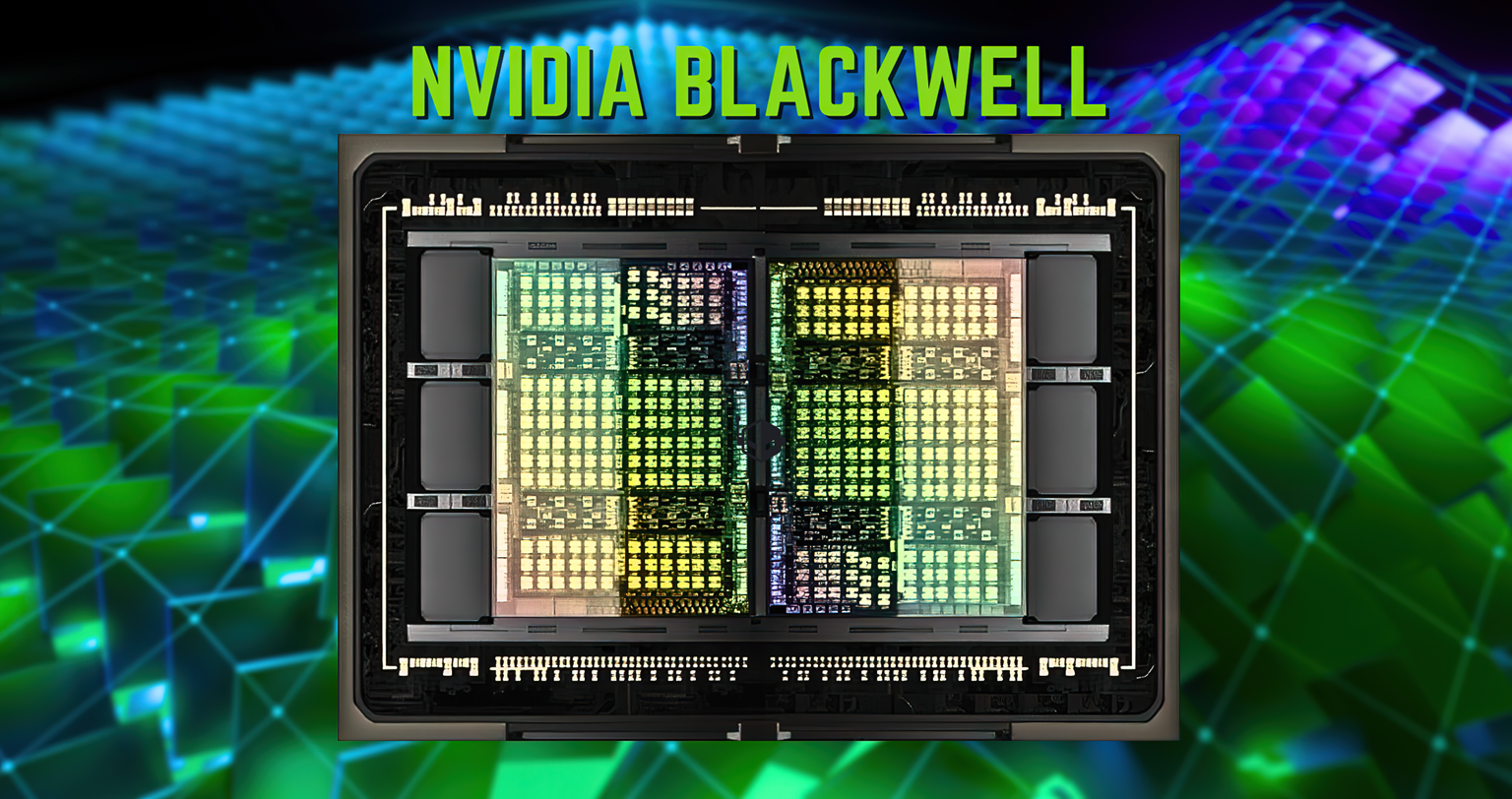
這對三星來說是個好消息,通過與英偉達達成交易,顯然可以看到其內存和 AVP(高級封裝)部門的經營狀況好轉,而且這傢韓國巨頭還能從AMD和特斯拉等公司獲得半導體、封裝和存儲器工藝的更多潛在訂單。