不久前,華碩在CES2023上展示與Intel合作開發的“超新星SoM”封裝技術。該技術將CPU、內存芯片與通信模塊整合到一起,從而為主板節省大量空間,使得容納更為高端的顯卡,或是提升整機散熱效率都成為可能。
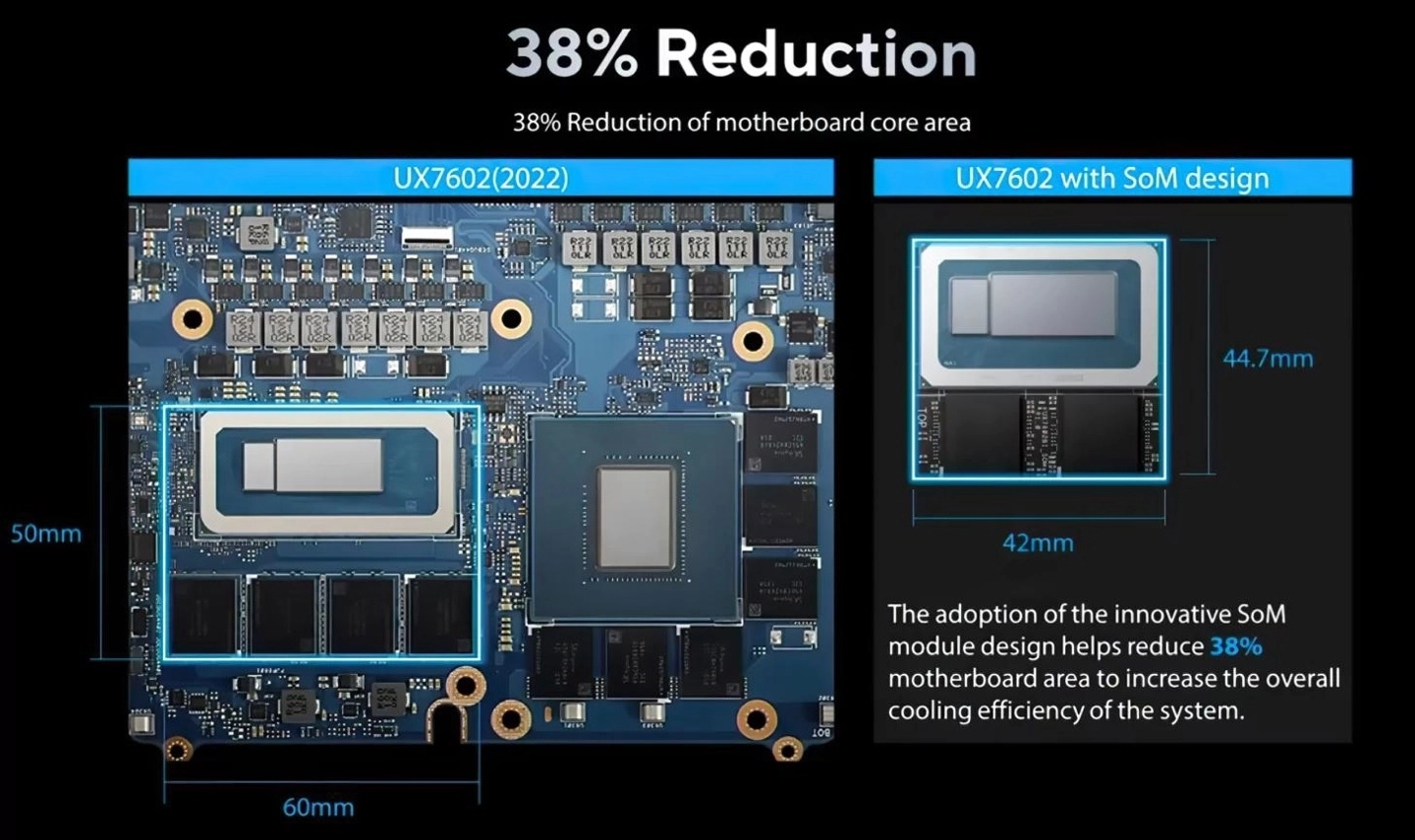
現在,華碩在CES上展示這一技術的實物。

從實物照片來看,超新星SoM封裝技術將占用主板面積從60 x 50毫米縮小到44.7 x 42毫米,從而節省38%的核心區域空間。
同時,“超新星SoM”封裝縮短CPU、內存之間的距離,讓內存頻率提高到7647MHz,相比標準的6000MHz讀寫性能提升20%,3D渲染速度提升1.7倍,視頻編輯速度提升2.4倍。
再配合超大面積VC均熱板、液態金屬散熱材質,高性能模式下可以實現155W的整機性能釋放。
據悉,“超新星SoM”封裝技術將首先在靈耀X Ultra上搭載。
